什么是bga芯片?bga封装工艺简介
标签:
bga
来源:华强电子网
时间:2022-11-22 17:52
摘要:bga芯片其实是一种错误的说法,BGA是一种封装模式,比如电阻,焊在主板上的。芯片是有引脚的焊在主板上的。而BGA是把焊点贴于芯片内部,然后全方位加热,焊接在主板上的。接下来了解一下BGA封装的相关介绍。
bga芯片其实是一种错误的说法,BGA是一种封装模式,比如电阻,焊在主板上的。芯片是有引脚的焊在主板上的。而BGA是把焊点贴于芯片内部,然后全方位加热,焊接在主板上的。接下来了解一下BGA封装的相关介绍。
一、什么是bga?
BGA的全称是Ball Grid Array(球栅阵列结构的PCB),它是集成电路采用有机载板的一种封装法。它的特点有:①封装面积减少;②功能加大,引脚数目增多;③PCB板溶焊时能自我居中,易上锡;④可靠性高;⑤电性能好,整体成本低。有BGA的PCB板一般小孔较多,大多数客户BGA下过孔设计为成品孔直径8~12mil,BGA处表面贴到孔的距离以规格为31.5mil为例,一般不小于10.5mil。BGA下过孔需塞孔,BGA焊盘不允许上油墨,BGA焊盘上不钻孔。
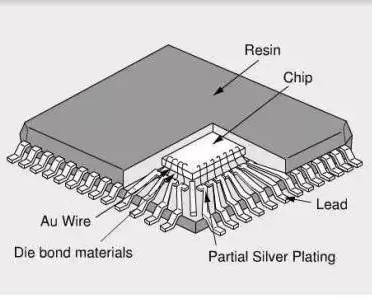
二、bga的特点
BGA与TSOP相比,具有更小的体积,更好的散热性能和电性能。BGA封装技术使每平方英寸的存储量有了很大提升,采用BGA封装技术的内存产品在相同容量,体积只有TSOP封装的三分之一;另外,与传统TSOP封装方式相比,BGA封装方式有更加快速和有效的散热途径。BGA封装的I/O端子以圆形或柱状焊点按阵列形式分布在封装下面,BGA技术的优点是I/O引脚数虽然增加了,但引脚间距并没有减小反而增加了,从而提高了组装成品率;虽然它的功耗增加,但BGA能用可控塌陷芯片法焊接,从而可以改善它的电热性能;厚度和重量都较以前的封装技术有所减少;寄生参数(电流大幅度变化时,引起输出电压扰动)减小,信号传输延迟小,使用频率大大提高;组装可用共面焊接,可靠性高。
三、BGA封装类别
到目前为止,BGA封装可根据基本类型分为三类:PBGA(塑料球栅阵列),CBGA(陶瓷球栅阵列),TBGA(带球栅阵列) 。
1、PBGA
PBGA将焊球置于基座上,具有以下特性:
2、CBGA
属于CBGA的焊球是用高温焊料制造的,然后通过共晶的应用与陶瓷基体连接焊料具有低熔点(通常为63Sn/Pb),然后利用该焊料使焊球与PCB(印刷电路板)连接。 CBGA具有以下特点:
3、TBGA
TBGA是一种利用磁带互连来实现芯片,焊球和PCB之间连接的封装。 TBGA封装的特性包括:
四、BGA的局限性
许多用户抱怨BGA焊点可视性差。很明显,BGA的焊点不能藉由肉眼检测。实际上,由于零配件引线数不断增加,任何现代电子组装制程都会出现这种情况。采用低成本的X射线装置,以及良好的设计规则,可以进行相对简单的检测。
现在的布线设计(footprint)包括印制导线组合、通孔和0.02英寸的圆形表面焊盘。器件上焊球的大小必然会影响焊盘尺寸。最初,一些工程师在焊盘表面贴上阻焊膜,以此减小回流焊期间器件的移动和焊膏的流动。采用这种方法,在加热过程中焊点容易开裂,因此不可取。
如果铜焊盘与阻焊膜涂层之间为标准间隙,则应采用标准阻焊膜设计规则。需要时,这种简单的布局允许在印制板两个表面走线。甚至间距为1或1.27mm的、I/O数较多的器件,焊球之间都会出现走线问题。选择间距较小,但中心“空白”(即无焊球)的器件,可克服这种问题。中心空白的BGA外边缘可能只有四列焊球,减少了走线问题。
以上就是bga封装工艺的相关介绍,随着笔记本越来越普及,所谓的BGA封装已简单到了不用任何检测和故障点判断的操作。